2.5D金倒装高频模块
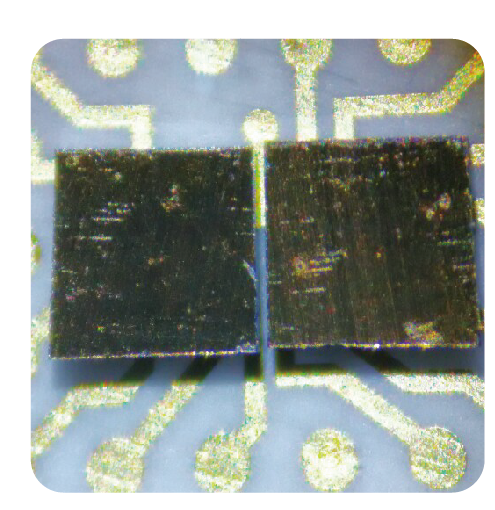
2.5D金倒装高频模块
封装特点:
过去2-3GHZ是IC封装的频率上限,采用Flip-Chip封装根据使用的基板技术可高达10-40 GHZ。金球倒装可有效缩短I/O引出距离< 15um,可在硅基板、陶瓷基板、玻璃基板和树脂基板载体上实现高可靠倒装焊接。
主要应用领域:
5G通讯、射频高频、光学影像
主要产品类型:
声表面波滤波器(Saw filter)、CMOS Sensor,LED,TCXO、Opto,RF Module等。
过去2-3GHZ是IC封装的频率上限,采用Flip-Chip封装根据使用的基板技术可高达10-40 GHZ。金球倒装可有效缩短I/O引出距离< 15um,可在硅基板、陶瓷基板、玻璃基板和树脂基板载体上实现高可靠倒装焊接。
主要应用领域:
5G通讯、射频高频、光学影像
主要产品类型:
声表面波滤波器(Saw filter)、CMOS Sensor,LED,TCXO、Opto,RF Module等。
封装形式:
LGA BGA SiP-LGA SiP-BGA
封装特点:
优越的电学及热学性能,高密度I/O引脚,封装尺寸大幅减少,高频性能佳。过去2-3GHZ是IC封装的频率上限,采用Flip-Chip封装根据使用的基板技术可高达10-40 GHZ。金球倒装可有效缩短I/O引出距离< 15um,可在硅基板、陶瓷基板、玻璃基板和树脂基板载体上实现高可靠倒装焊接。
应用领域:
5G通讯、射频高频、光学影像、光电转换等
主要产品类型:
声表面波滤波器(Saw filter)、CMOS Sensor,LED,TCXO、Opto,RF Module等。
![]()
上一个:
uModule微模组
下一个:
MEMS气体传感器