金倒装互连和晶圆级金凸点成球技术,您了解吗?
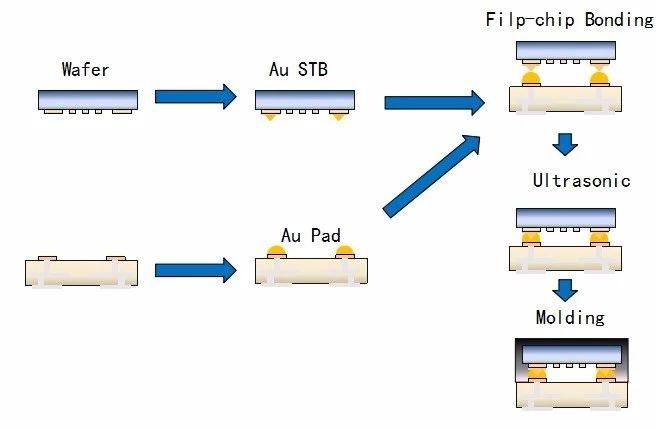
超声热压金倒装互联技术
高性能、高可靠、体积小、重量轻是消费电子、工业电子、汽车电子、医疗电子、军用电子器件的共同需求和发展方向。为满足微电子封装微型化、高性能的要求,芯片倒装将是主要互连形式。芯片倒装互连技术是在芯片焊盘上做凸点,然后将芯片倒扣于基板进行凸点与基板间的连接,凸点连接比引线键合连线短,传输速度高,其可靠性提高30~50倍。倒装芯片在电子封装互联中占有越来越多的份额,金球凸点倒装封装技术是当今最先进的倒装封装技术之一,目前国内还处于起步阶段。
金凸点比回流焊凸点的导电、导热性能高10倍,金为较软金属,当前业界已开始采用热声倒装键合完成金凸点互连,目前主要应用于LED、CMOS sensor、Opto Sensor、SAW、RF-Switch、RF module等产品领域,其金球倒装工艺流程相对简短,低成本,绿色环保,已显示其独特的技术优势和前景。苏州捷研芯在此技术领域达到国内领先,国际一流水准,对本公司和本行业都将产生积极的影响,特别是金凸块超声热压倒装焊接在硅基板和陶瓷基板上的应用。
金凸块倒装互联技术可实现器件更好的信号完整性,过去2-3GHZ是IC封装的频率上限,采用金凸块封装技术可高达10-40 GHZ,同时由于不需要经过高温,因此对器件本身也没有内应力损伤,是未来高端芯片封装的发展方向,更是5G高速高频时代封装的首选方案之一。
此技术发达国家已经开始在超高频产品(军用或通讯导航)上获得应用,在MEMS声波滤波器领域已广泛应用,目前国内还刚刚起步,有一定的技术难度,但市场应用前景广大.苏州捷研芯在长三角范围内第一家具有金球成球和热压超声焊接的技术开发能力的声波滤波器封装企业。

图1 Au热压超声焊接
晶圆级金凸点成球技术
超声倒装焊是在超声能量、压力及热的共同作用下,实现芯片I/O 端口与基板之间的直接互连。热超声倒装焊具有封装可靠性高、连接效率高、工艺简单、成本低、适应性强等优点,较低的焊接温度降低了在凸点与焊盘间形成金属间化合物的可能性,同时又是一种无铅的绿色焊接,被认为是满足下一代芯片封装要求的具有发展潜力的新工艺和新技术。晶圆级金凸点成球技术是实现金球倒装互联的首要前提,苏州捷研芯引进美国成套量产设备和工艺,兼容4~12inch晶圆金凸点制作。
主要技术指标为:
1)焊球尺寸:焊接前62+/-5um,焊接后90+/-10um;
2)焊球间距:Min90um;
3)焊接后互联高度:10~20um;
5)焊接强度:推力测试>18g/金球;
6)样品可承受短时(~2 min)300℃高温;
7)存储温度测试:-65℃~+125℃无焊点虚焊;
8)温度冲击实验,转换时间不大于5 min,循环次数500次。

图2 Stud bump
苏州捷研芯引进、消化、吸收国外最新芯片级封装技术,通过再创新实现了核心器件封装的国产化。已经与国内设计公司合作开发出1.4X1.1mm、1.1X0.9mm等CSP封装型声表面波滤波器产品,是国内率先推出此类微型化产品封装的少数封装代工厂之一!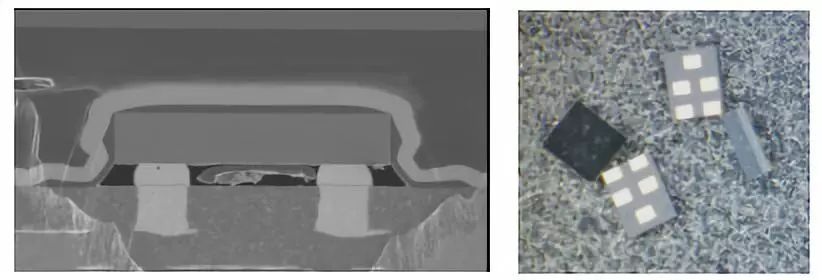

图3 1.4X1.1mm CSP Saw filter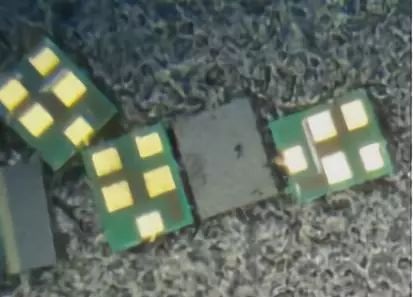

图4 1.1X0.9mm CSP Saw filter



